作為一項(xiàng)相對較新的技術(shù),氮化鎵(GaN) 采用的一些技術(shù)和思路與其他半導(dǎo)體技術(shù)不同。對于基于模型的GaN功率放大器(PA) 設(shè)計(jì)新人來說,在知曉了非線性GaN模型的基本概念(非線性模型如何幫助進(jìn)行GaN PA 設(shè)計(jì)?)后,了解I-V 曲線(亦稱為電流-電壓特性曲線)是一個(gè)很好的起點(diǎn)。本篇文章探討I-V 曲線的重要性,及其在非線性GaN 模型(如Modelithics Qorvo GaN 庫里的模型)中的表示如何幫助您更精確、更高效地完成設(shè)計(jì)流程。
場范圍(pitch) 是什么?
您可將I-V 曲線看作一個(gè)足球場(有時(shí)也稱為“pitch”),其限值決定了微波信號的邊界,如下圖所示。簡而言之,一旦觸及邊界,就會(huì)發(fā)生信號削波,這會(huì)導(dǎo)致壓縮和非線性失真。邊界值由以下參數(shù)設(shè)置:
· 拐點(diǎn)電壓和最大電流(Imax),由圖中角上的標(biāo)記m1 表示· 零電流線,對應(yīng)于柵極-源極夾斷電壓(Vpo)
· 擊穿電壓(VBR),由右邊電流曲線的上升沿表示
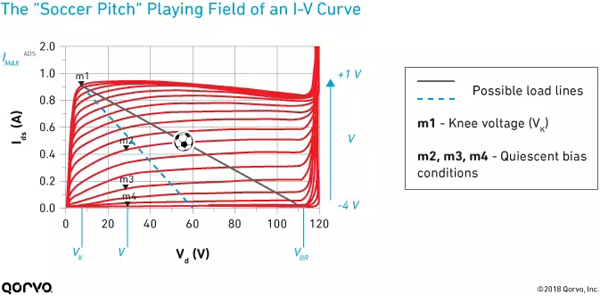
基于Modelithics Qorvo GaN 庫的圖形而重新創(chuàng)建
拐點(diǎn)電壓、偏置條件和增益
該圖還顯示了以下信息:
· 標(biāo)記m1 表示拐點(diǎn)電壓(Vk)。· 標(biāo)記m2、m3 和m4 表示標(biāo)稱靜態(tài)偏置條件,分別代表A 級、AB 級和B 級常規(guī)PA 工作級或模式。當(dāng)然,還有其他模式,例如C 級偏置對應(yīng)于比夾斷電壓更低的負(fù)柵極電壓,因此射頻電流導(dǎo)通時(shí)間小于柵極電壓輸入波形的半周期。
不同的曲線代表不同的柵極-源極電壓值,從夾斷值(本例中約為?4 V)到微正值(Vgs = 1 V)。本器件允許的絕對最大電流(Imax) 約為900 mA,擊穿電壓(VBR) 約為118 V。
不同Vgs 值的I-V 曲線的間距與所謂的跨導(dǎo)(gm ≈ ΔIds/ΔVgs) 有關(guān),跨導(dǎo)與增益有關(guān)。(圖中Vgs 的階躍電壓為0.2 V。)請注意,在m4(B 級偏置)附近,與m3(AB 級)相比,曲線間距更近。AB 級具有與B 級相似的效率優(yōu)勢,并且增益更高,這是其成為首選的原因之一。
可獲得多大的射頻功率?
上圖還顯示了一條藍(lán)色虛線和一條深灰色實(shí)線,用于表示交流信號會(huì)往復(fù)擺動(dòng)的負(fù)載線路。在理想意義上,深灰色線考慮到最大限度地利用I-V“運(yùn)行場”,并允許信號充分利用最大電流和最大電壓擺幅。
在本例中,靜態(tài)偏置電壓原則上可設(shè)置為61 V。但是,出于可靠性和設(shè)計(jì)裕量的考慮,我建議使用更低的標(biāo)稱偏置電壓(始終小于擊穿電壓的一半)和不同的最佳負(fù)載線路(這里我們選擇了28 V,在上圖中標(biāo)記為m2、m3和m4)。器件的潛在功率(對于A 級和B 級)可以簡單地用0.25*(VdsQ-Vk)*Imax 來大致估算。此處所示器件的輸出功率約為5 W。
對于給定的工藝,擊穿電壓趨于恒定值,因此可以通過增加?xùn)艠O寬度來獲得更高功率。這將引入一個(gè)衡量功率性能的常見參數(shù),稱為功率密度,GaN 的功率密度為5-10 瓦/毫米(W/mm) 柵極寬度,GaAs 晶體管的功率密度為0.5 至1 W/mm。
簡而言之,為了在削波前使電流/電壓峰值達(dá)到最大值以優(yōu)化功率輸出,負(fù)載電阻將是負(fù)載線路斜率的倒數(shù)(忽略器件和封裝的反應(yīng)性寄生效應(yīng))。最佳功率負(fù)載總是不同于按照線性電路理論所得出的最大程度提高器件增益所需的功率負(fù)載。
GaN 擴(kuò)大I-V“運(yùn)行場”的能力
回到對功率性能的簡單估算,0.25*(VdsQ-Vk)*Imax,因此,可以通過使用以下器件獲得更高功率:
· Imax 值更高的器件· 可在更高靜態(tài)電壓下運(yùn)行的器件
· 兩者兼具(更高Imax 和VdsQ)的器件
商用GaN 工藝的擊穿電壓在100 V 和200 V 之間,比GaAs 的擊穿電壓高出一個(gè)數(shù)量級,也是典型LDMOS 工藝的兩倍以上。GaN 有效地?cái)U(kuò)展了上述I-V 運(yùn)行場的邊界,對于高功率PA 設(shè)計(jì)而言,這種I-V 曲線擴(kuò)展非常令人振奮。
是否存在讓我們擔(dān)擾的陷阱?
俘獲效應(yīng)是影響GaAs 和GaN HEMT 器件工作的一個(gè)電學(xué)現(xiàn)象。它發(fā)生于器件的外延層,其中可用于增強(qiáng)HEMT 溝道中電流的電子實(shí)質(zhì)上被“陷”入缺陷狀態(tài),該缺陷發(fā)生在GaAs 或GaN 格柵表面或內(nèi)部。這種效應(yīng)具有電壓依賴性,并隨時(shí)間推移會(huì)降低器件的運(yùn)行性能,影響拐點(diǎn)電壓之類的參數(shù)。
GaN 俘獲效應(yīng)的一個(gè)眾所周知的影響稱為拐點(diǎn)蠕變,它將使I-V 曲線的拐點(diǎn)電壓右移,如下圖所示。

好消息是非線性GaN 模型可幫助預(yù)測這種俘獲效應(yīng)的行為。下圖顯示了Modelithics Qorvo GaN 模型中捕獲的一個(gè)Qorvo 裸片模型的I-V 曲線。它顯示了在短脈沖條件下(例如0.05% 占空比下0.5 µs 脈沖寬度)的兩種不同靜態(tài)漏極電壓(12 V 和28 V,下圖中標(biāo)記為VdsQ1 和VdsQ2)的仿真。

基于Modelithics Qorvo GaN 庫的圖形而重新創(chuàng)建
您可看到拐點(diǎn)電壓和Imax 如何受到與陷阱相關(guān)的拐點(diǎn)蠕變效應(yīng)的影響。將自熱參數(shù)輸入值設(shè)置為零時(shí),該模型數(shù)據(jù)很好地再現(xiàn)了在12 V 和28 V 靜態(tài)漏極電壓(VgsQ 設(shè)置為夾斷值)短脈沖條件下測得的I-V 曲線。
我們從上述討論中得知,這兩個(gè)參數(shù)會(huì)相應(yīng)地影響器件的最大功率,因此模型隨工作電壓而跟蹤I-V 變化的能力將十分重要,具體取決于應(yīng)用。
非線性模型可加快設(shè)計(jì)流程
了解I-V 曲線的影響和細(xì)微差別及其對PA 設(shè)計(jì)的基本限制和影響十分重要。如果您是這個(gè)領(lǐng)域的新手,希望本文有助于您了解I-V 曲線中許多有用的信息!
選擇負(fù)載條件以最大程度地提高大信號功率性能,這與線性共軛匹配的思路完全不同,因此在設(shè)計(jì)流程中使用非線性GaN 模型可幫助您第一次就獲得正確設(shè)計(jì)。無需過多擔(dān)心與晶體管的輸出阻抗匹配,我們需要考慮的是如何最大程度地提高I-V“運(yùn)行場”上的電流和電壓變化擺幅,這由I-V 曲線的邊界值控制,從拐點(diǎn)電壓和最大電流沿著選定的負(fù)載線路下降至夾斷區(qū)域。

 粵公網(wǎng)安備 44030902003195號
粵公網(wǎng)安備 44030902003195號